探索芯片设计/结构散热/信号完整性解决方案,从显卡芯片仿真说起
- 作者优秀
- 优秀教师/意见领袖/博士学历/特邀专家/独家讲师
- 平台推荐
- 主编推荐/内容稀缺



一、显卡的芯片仿真问题
我国芯片行业卡脖子,主要是在于高端制程领域。国内最高制程能力是14nm,但受限制裁只也能制造不能量产。正因如此,国外的一些高端芯片我们根本没法自行生产,并且在美国的封锁下,有一些可能成功苗头的公司很快就会被美国上了禁令而遭受重创。
显卡芯片就是一种利用高制程才能获得高性能典型。在人工智能、大数据等计算需求旺盛的时代,显卡畅销,推动NVIDIA这样的顶级显卡公司股票飞涨。A100是NVIDIA的畅销卡代表,7nm的制程。在这张卡里除了制造问题外,设计也是有很多学问和困难。
这张卡中心是芯片,利用2.5D封装将6个HBM(High bandwidth memory)和一颗GPU合封在interposer上面,并且将芯片molding一起,然后背面磨掉露出硅来散热。这里面有散热,力学以及信号完整性等各种问题。

该卡是全长全高(Full length full height) form factor, 300W功耗,双卡槽风冷或者单卡槽水冷。尺寸和功耗是确定散热方法最重要的参数。通常散热仿真需要把从热源开始到散热器全部建模,原因是需要构建最重要的热通路,热通路的特点就是热阻相对最小热流密度最大的导热路径。在构建过程中,所有会影响热通路热阻的特征都要仔细建模。比如硅背面和散热器之间的导热硅脂,是可能有很大热阻的。热量主要导热路径就是从GPU通过导热硅脂到散热器过程。当然还有个对热极其敏感的HBM在旁边。
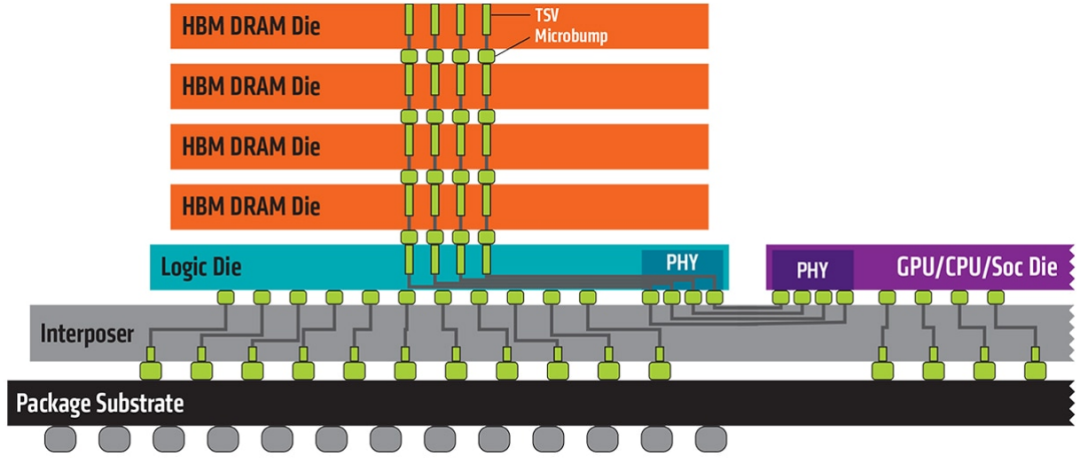
HBM是个多层的器件,利用TSV(Through silicon via)和Microbump将每一层DRAM器件连接在一起。每一层的Microbump需要有underfill或者molding保护。这多层异质结构会引起内部应力以及散热问题,因为每层之间由于保护材料导热极差(小于1W/m.K),不管选择从上面还是下面导热,另外一边的层都需要经过多层microbump层而导致热阻极大,多层之间温差大而应力大导致HBM性能不稳定甚至失效。
说到应力,是属于力学范畴,就不能不说翘曲。翘曲分析是封装设计必须做的评估。翘曲指的是由于异质结构的CTE(Coefficient of temperature expansion)不同,整个封装会在升温或者降温过程下导致bump焊接面的不平,bump会有断开、虚焊、桥接接等各种问题,最终导致焊接失败或者失效。焊接问题是封装失效的主要问题,也是大量工程师和科研人员研究的问题。

最后这样一个高性能计算显卡(high-performance computing (HPC) graphics card),芯片计算过程中需要随时与HBM进行数据交换,同时整个卡与背板的交换机(Switch)也需要高速通信,使用PCIe Gen4的协议。这些所谓的高速都是指data rate,即每秒的传输量,单位是GB/s。速率提高会带来信号完整性问题(Signal Integrity),导致接收器件不知道信号发生器件在说什么。GPU和HBM的通信协议和GPU与switch的通信协议是不同的,因为使用场景不同。GPU与Switch之间由于路程较长,损耗较大,PCIe的协议有弥补大损耗的特点,而且通道数量并不多,因为大量的通道数会占用大量板上面积以及IO数量。GPU和HBM之间协议则可以使用大量通道数量,单个通道不需要太高,因为通过interposer走线线宽可以很窄,从而节约面积。但它们共同特点是都不会有太多margin,需要非常仔细的仿真与校核,保证项目成功落地。
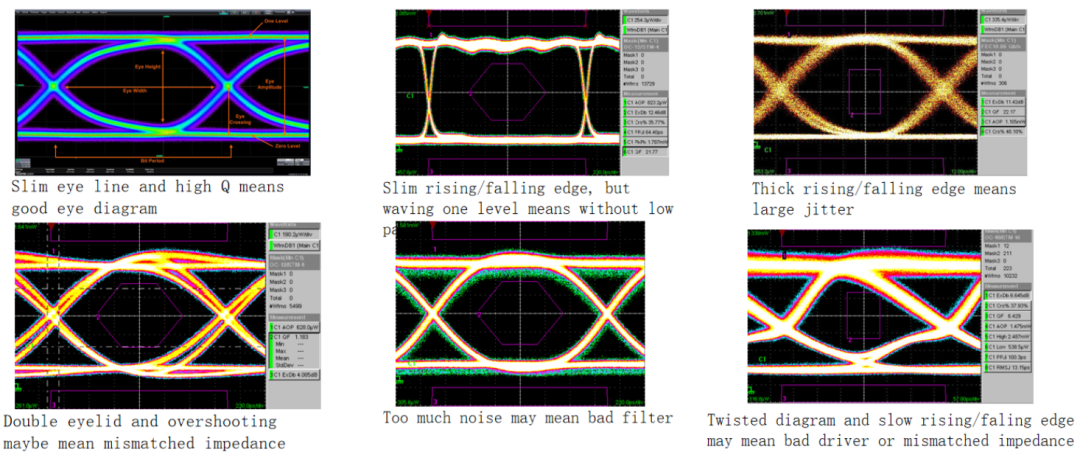
A100的技术难点并不只是在芯片的制造上面,更多的多领域工程师配合完成的作品。现在摩尔定律将要达到极限,高制程的神话或许即将终结,我国的芯片发展也是遇到百年难遇的契机。

二、芯片设计仿真技术
现在Chiplet的封装方案被认定为延续摩尔定律的最佳解决方案,也是利用interposer将各个不同功能芯片封装在一起,做出多层功能芯片利用TSV连接在,被称为3D封装。HBM就是一种3D封装,不过是属于小规模的3D封装,大规模的3D封装中热、应力以及信号完整性问题会更加严峻,等待有经验的工程师去解决。
3月23日至4月20日,仿真秀将邀请芯片行业资深的芯片封装工程师带来6场讲座,一起探索芯片设计、结构散热、SIPI和EMC仿真解决方案。请点击下文报名任意报告观看或回放。

报告时间:3月23日19时30分
主讲嘉宾:曾家麟 中央大学机械工程博士,仿真秀专栏作者,某知名厂商仿真团队技术总监,加拿大国研院计算中心访问学者/西门子流体仿真顾问 ,从事ANSYS CFD及CAE等仿真技术近20年。历任国内外电子厂及系统厂仿真设计主持人,并从事科研单位合作,培养国内仿真水平,针对结构、流体、热传及多物理场耦合相关应用具备丰富客户与设计经验,熟知产业结构痛点、流体设计及散热议题,并具备上百个客户项目经验。目前职司国内知名厂商工程技术团队负责人,协助解决客户各方面仿真应用问题。
用户得到:通过本讲座,用户可以清晰芯片级仿真系统中ECAD如何导入Icepak做热仿真,及热仿真相应耦合入Mechanical做结构计算,如翘曲等问题。相关的设置及技巧也会在分享中逐一解释与呈现。
ANSYS ECAD技术介绍 Icepak ECAD热仿真方法 Mechanical ECAD结构仿真方法 电路/热/结构联合仿真技术
报告时间:3月30日19时30分
主讲嘉宾:Jacky_杨,桂林电子科技大学硕士,仿真秀专栏作者,主要从事封装基板设计,包括封装基板设计(2-10层以上,包括BT基板和ABF板,框架(传统QFN框架和MiS框架设计),仿真包括封装热仿真(输出热阻和结温等),封装应力仿真(包括封装翘曲和应力等),电仿真(包括信号完整性和电源完整性等);熟悉国内外多家基板厂工艺能力和封装工艺能力,参与的封装基板项目包括WB-LGA设计、WB-BGA设计、FC-BGA设计、WB-FCBGA设计、POP设计、堆叠设计、埋入设计等,其中覆盖的产品类型包括军工、医疗、电源等。
用户得到:讲座主要围绕项目前期如何进行基板评估以及评估需要注意事项等,另外,还介绍了国内基板厂通用的基板设计规范和封装设计规范,最后展示实际案例成果。
报告时间:4月8日19时30分
主讲嘉宾:惊堂木 电子封装系硕士,仿真秀专栏作者,某知名芯片厂封装仿真工程师,熟悉封装领域散热设计与应力仿真。

用户得到:讲座将分享芯片封装领域的一些热仿真研究的内容。JEDEC热阻测试标准与热仿真模型; 单芯片热阻网络模型的应用与热阻网络的提取; 瞬态热仿真与瞬态热阻的应用; 最后分析一些常见封装散热优化方案。
JEDEC 热测试标准解读与对应热仿真模型; 封装中复杂热阻网络模型提取与应用; 封装瞬态热阻(R-C热阻抗)介绍; 封装散热优化方案分享。
报告时间:4月15日19时30分
主讲嘉宾:张宗兵,高级电磁应用工程师,仿真秀专栏作者,研究生学历,多年电磁CAE工程经验,毕业于西安电子科技大学,无线电物理专业,计算电磁学方向,师从郭立新教授,高级职称,工作前几年专门设计电磁产品,包括天线,滤波器,连接器,耦合器,阻容感,芯片等等微波部件,后工作于ANSYS业务专门做电磁产品技术支持,任高级电磁应用工程师,解决大量电磁仿真及EMC设计仿真问题。
报告五:5G高速互连仿真技术与射频毫米波PCB设计(点击这里报名观看)
报告时间:4月20日19时30分
主讲嘉宾:林超文,实战型高速PCB设计专家,仿真秀专栏作者,深圳市英达维诺电路科技有限公司总经理,著有《Altium designer实战攻略与高速PCB设计》、《高速高密度PCB设计攻略》等多本PCB工程技术著作。
擅长高速高密度PCB设计,并高效指导研发人员开展高速PCB设计,提高产品开发效率、提升产品设计质量。通过长期不懈的学习、探索与总结,已初步形成了一套系统化高速PCB设计的实践经验及理论。目前专注于为企业提供信号完整性设计、PCB Layout设计、高速PCB设计及仿真培训等服务,已为百余家企业提供信号完整性设计及培训服务。
报告六:DFM仿真分析加速IC应用测试验证(点击这里报名观看)
报告时间:4月26日19时30分
主讲嘉宾:刘久轩 上海望友信息科技有限公司NPI技术总监,仿真秀专栏作者,拥有十五年以上的电子制造行业工作经验,熟悉电路板设计和装配制造工艺流程,曾主导或参与客户电装智能制造方案服务实施200多家,对NPI工具理解深刻,具有丰富的DFx应用和体系实施经验。

通过本讲座,用户可以学习ECAD数据如何导入DFM软件进行高效开短路分析,及IC在单板上的虚拟测试验证分析方法。相关线路分析规则、可制造性工艺知识分享。
DFM支持的ECAD数据类型
集成电路开短路分析方法
DFM仿真分析方法
DFM与EDA交互
三、芯片设计仿真学习路线
在芯片设计过程中,物理仿真是非常重要的一环,它可以帮助设计人员在芯片设计前预测芯片的性能、稳定性和可靠性,从而优化设计、减少试错成本。
1、物理仿真的应用主要有以下几个方面:
(1)设计验证:通过对芯片的物理仿真:可以验证设计的正确性,检查是否存在设计缺陷或潜在的问题。在这个阶段,设计人员通常会使用电路仿真软件,比如SPICE(Simulation Program with Integrated Circuit Emphasis)等。
(2)电磁兼容性(EMC):在芯片设计中,需要考虑到芯片与其他电子设备的互相干扰问题。通过物理仿真,可以对芯片进行EMC分析,预测芯片的辐射和敏感性,从而进行优化和调整。
(3)热分析:芯片在工作过程中会产生热量,热量的积累会影响芯片的性能和寿命。通过热仿真,可以模拟芯片在工作状态下的温度分布,从而优化散热设计和材料选择。
(4)可靠性分析:芯片在使用过程中需要具备一定的可靠性。通过物理仿真,可以模拟芯片在不同工作状态下的寿命和可靠性,从而评估设计的合理性。
2、在进行物理仿真时,需要掌握以下几种技术:
(1)电路仿真技术:电路仿真是最基本的仿真技术,通过对电路的电学特性进行仿真,可以验证电路的性能、可靠性和稳定性。
(2)有限元分析技术:有限元分析(Finite Element Analysis,FEA)可以对芯片的机械、热力学和电磁学特性进行仿真分析,包括芯片的应力、应变、热量分布、电磁场分布等。
(3)计算流体力学技术:计算流体力学(Computational Fluid Dynamics,CFD)可以对芯片周围的空气流动进行仿真,从而预测芯片的散热情况。
(4)可靠性分析技术:可靠性分析技术可以对芯片的寿命、可靠性和故障率进行仿真分析,包括加速寿命测试(Accelerated Life Testing, ALT)和失效模式和效应分析(Failure Mode and Effects Analysis,FMEA)等。
3、芯片设计好内容
自2019年以来,仿真秀平台持续致力于仿真优质内容的创作,尤其是芯片设计相关内容,一直在探索芯片设计仿真学习路线,希望能够帮助芯片设计仿真学习者更高效的学习和掌握相关技能。3月23日-4月20日,芯片设计仿真好课推荐:请点击下图试看和订阅。

以下是仿真秀-芯片设计仿真学习包,持续更新永久免费。