行业应用方案 | 2.5D/3D 芯片封装
Ansys 行业应用方案连载(5) | 2.5D/3D 芯片封装
随着半导体工艺的不断缩小,物理极限制约着工艺的进一步发展。2.5D/3D IC先进封装技术通过堆叠2D芯片,并在3D方向进行连接,有望进一步提升芯片集成密度,并且显著减小互联延时和互联密度,挖掘系统的性能潜力,系统的功耗也得以降低。2.5D/3D IC封装提供了比以往都要灵活的方法,把不同技术的集成电路进一步集成,如存储器和逻辑电路、射频(RF)和混合信号组件、光电子器件等,为实现小而强大的系统提供了新方向。
2.5D/3D IC封装提供更高集成度的同时,也引入了非常多的挑战。布线尺寸的减小增加了互连线之间的干扰,芯片间距的缩小增加了相互干扰,发热将会成为约束系统的关键问题,必须对热进行合理的规划和管理,多芯片的堆叠也增加了应力开裂的风险。Ansys CPS Platform提供了从芯片,封装,PCB,系统级的多物理层耦合的仿真平台,覆盖电磁,电热,应力多个学科。Ansys成熟的解决方案,成熟的工具配套,广泛的用户群体,为2.5D/3D IC的产品设计提供了强有力的支撑。
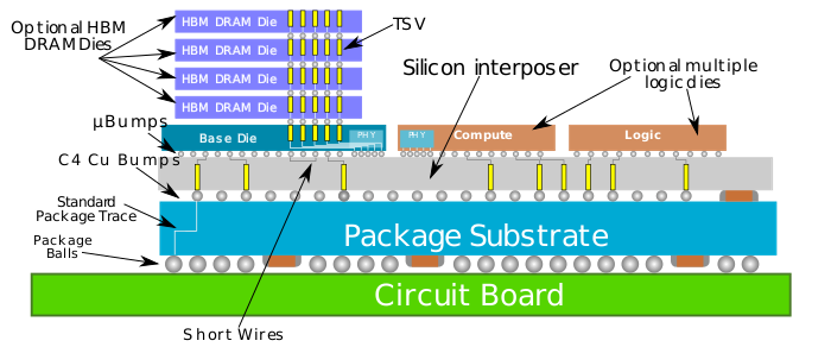
Chip-on-Wafer-on-Substrate (CoWoS) 工艺(图片来源:wikichip)
Ansys解决方案
一
Interposer参数提取和设计优化
Interposer作为2.5D/3D IC互联的载体,精确的互联参数提取是非常重要的一个环节,HFSS/SIwave可以提供多种求解器。
HBM IO的参数提取和优化
高速SERDES的参数提取和优化
RF隔离度
On-Chip电感,电容求解
CPA快速参数抽取
 Interposer参数提取和设计优化流程
Interposer参数提取和设计优化流程
 Interposer GDS导入向导
Interposer GDS导入向导
二
PI 分析
HFSS/SIwave可以对Interposer, Package, PCB等组成的系统进行DCIR, PDN, Noise等指标进行分析,结合Ansys Redhawk输出的高精度CPM电源模型,实现高精度的CPS分析。
Interposer/Package压降和载流密度分析
CPS PDN参数提取和优化分析
CPS 电源Noise分析

Interposer/Package压降分析案例
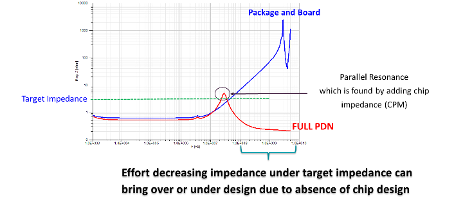
CPS PDN参数提取和优化分析
三
SI 分析
HFSS/SIwave进行高速接口分析,结合CSM、CPM模型,对接口的SSN噪声、信号质量、眼图、抖动指标进行分析。
HBM SSN分析
高速SERDES分析
其它IO分析
 HBM SI分析
HBM SI分析
四
电热耦合分析
电热是2.5D/3D IC设计的重点,Icepak结合Ansys CTM模型,可以实现高精度的热可靠性分析
铜箔/焊球载流能力分析
2.5D/3D IC热分布热点分析
2.5D/3D IC高精度CPS电热耦合分析
EM电迁移分析
 Ansys电热耦合分析解决方案
Ansys电热耦合分析解决方案
五
热应力分析
热应力会导致芯片局部可靠性问题,甚至开裂的风险,SIwave Icepak CTM Mechanical提供高精度的2.5D/3D IC热解决方案。
2.5D/3D IC热应力分布
裂纹分析
翘曲分析
焊球疲劳分析
跌落冲击
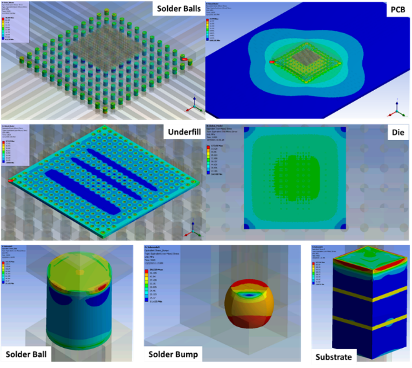
焊球应力分析应用
Ansys助力2.5D/3D IC先进封装设计,提供SI/PI/EMC、电热、应力疲劳等全方位解决方案
Ansys是业界唯一可以提供从系统到芯片的多物理场耦合的解决方案。2.5D/3D IC高性能先进封装的设计挑战,要求设计者的观念从对芯片、封装和电路板孤立分析的解决方案向更加系统化全面分析的CPS多物理场(Multi-physics)解决方案转变。随着设计余量的不断压缩,设计者必须有效的去考虑系统和芯片的影响,站在整个CPS (Chip Package System) 的完整链条上去考虑封装参数的设计和优化。
2.5D/3D IC通过Interposer实现高密度的互联,Interposer上的高速布线需要精确的评估和设计,同时要考虑各个模块之间的干扰影响。
热对电性能的影响将变得更加严重,封装作为载体,需要考虑如果为IC提供散热通道,同时热也会影响封装上电性能的传输,电的传输也是产生热的一个源头,电热耦合设计不可避免。
高功率密度,高温环节,多颗Die的聚合,多种材料的接触,不可避免的会产生热应力问题,甚至造成产品失效,热和应力的耦合也变得非常重要。
2.5D/3D IC先进封装设计必须全面考虑芯片,封装,PCB,系统的影响,同时在电,热,应力之间找到一个合适的平衡点。Ansys的CPS多物理场耦合平台,提供了解决上述问题的全部方案,不同层级的设计人员,都可以在这个平台上找到对应的解决方案,使用Ansys最新的设计工具和方案加速设计的研发,获取最佳产品性能,缩短研发周期,在市场上保持产品的创新和领先。