当芯片设计遭遇3D瓶颈...
本文原刊登于semi.org:《IC Design Crashes Into the 3D Wall: Multiphysics Platforms Ride to the Rescue》
作者:John Lee

三维集成电路(3D-IC)彻底变革了半导体行业的发展。3D-IC通过堆叠和互联裸片制造,因此它们可以作为单个设备运行,通过提升性能和带宽实现更多功能,同时还能降低功耗、封装尺寸和成本。
然而,3D-IC给工程师带来严峻的设计挑战。因为显著大于单芯片片上系统(SoC),3D-IC拥有更多组件、更多集成点和更长的互联,这将造成高频信号故障、可靠性和其他性能问题(比如热积聚)等新风险。
随着芯片和系统之间的界限不断模糊,工程师必须开展并行的多变量分析,才能评估每种可能的故障模式——不仅在组件层面,而且在整个3D-IC总成上开展分析。对习惯以顺序方式应用一系列单物理工程仿真工具的许多研发团队来说,这形成了技术障碍。
3D-IC使用串行分析方法装配在复杂的封装内,该方法没有充分考虑系统级交互以及可能发生故障的数千个凸块连接点。相反,并行、多变量仿真与分析从设计的最初原型制作阶段就同时考虑了所有物理因素。
大多数半导体研发团队不仅缺乏开展这种复杂仿真与分析的技术工具,而且在进行系统级分析时,还面临文化上的障碍。采用不同工具的多元化团队根本无法从早期阶段就在复杂的3D-IC设计上进行无缝交接和有效协作。相反,他们往往要在后期阶段争先解决系统级问题。此时很可能导致发布延迟,返工成本高,而且他们对设计的积极影响也变得微乎其微。
真正的多物理场、多变量方法的价值
随着市场对3D-IC的需求日益增加,半导体研发团队需要统一仿真平台在整个总成上同时开展多物理场分析,包括电源完整性、可靠性、电磁(EM)、热、计算流体动力学(CFD)和力学研究。
统一的仿真平台融合了各物理场上业界最佳的解决方案,帮助半导体工程师跨部门开展协作,在仿真工具之间无缝交接分析任务,合作优化3D-IC设计的每一项性能参数。当研发团队制作物理原型以帮助确保按时、低成本地推出产品时,无论是信号完整性、热导率还是结构强度,发生高成本意外的可能性大幅降低。

图为芯片堆栈进行同步多变量分析示例:显示了热梯度以及封装在早期原型阶段的机械应力/翘曲
相反,按顺序应用多个物理场可能会造成持续不断、成本高昂的负面影响。例如,当一个团队解决信号完整性问题时,另一个团队可能会发现出现了时序故障或热风险。这不仅需要返回到设计图纸,还需要在互不相连的仿真分析工具间以及在职能部门间重复一系列耗费时间和各种资源的交接。
考虑全新物理场因素很重要
由于面临快速推出创新型3D-IC设计的压力,研发团队可能倾向于关注现有的签核指标。在如今的多裸片总成中,这些指标已足够复杂,但忽视了应用更新的物理因素。这是一个错误的做法,可能导致现场故障、产品召回、质保费用和对品牌声誉的持续损害。
为了在整个3D-IC系统上建立完全的产品信心,半导体工程团队需要一套解决方案和相关的最佳实践。这样既能快速直观地优化性能与成本,又能并行分析影响电气可靠性、机械稳定性和热失效模式的新物理因素。

需要精细仿真的物理效应数量与摩尔定律同步增加,在3D-IC设计中甚至进一步增加
采用统一的联网平台能够实现这种真正的多物理场分析。多物理场平台应与常用设计系统接口,并且可以通过Python API扩展到用户和其他厂商。
例如,工程师可以根据每个焊接凸点承载的电流来检查其热行为以及熔化与局部失效的可能性。工程师可以应用计算流体动力学评估风扇和散热器产生的气流如何有效地冷却总成。通过检查分布式供电网络上的低频功率振荡等不常见的效应,他们可以最大限度地提高系统可靠性。
最值得一提的是,统一的专用仿真平台允许半导体研发团队同时开展所有这些研究,以快速揭晓在复杂总成中将众多元件结合在一起时产生的设计权衡。随着3D-IC设计逐渐占领全球市场,只有这种类型的多物理场、多变量并行方法才能让工程团队实现其在速度、可靠性、创新和产品性能方面的所有目标。
支持纵向整合文化
半导体行业和电子行业的全球领导者受益于基于纵向整合的文化和组织模式,其支持高水平的设计协作。对于横向整合的小型企业来说,建立这种深度的协作相当困难。

客户需要一种开放式、可扩展平台,以支持跨越许多不同抽象级(从器件到芯片到电路板再到系统)的各种分析工具
正确的仿真技术平台能提供有力的帮助。一个将跨职能工程团队聚集在一起开展同步而非顺序的多物理场设计的共享平台,能够轻松实现跨越职能部门的无缝协作,并支持在功耗、性能、可靠性和成本的各个方面实现卓越。
通过同步优化温度、机械应力和其他微妙的效应,以实现这些基本性能相关方面的平衡,半导体工程团队能够在3D-IC变革中抢占领先地位,而不是成为追随者。
关于作者

John Lee是Ansys电子和半导体业务部的总经理兼副总裁。Lee曾是Gear Design Solutions(现为Ansys)的共同创始人兼首席执行官,该公司率先开发了面向集成电路设计的专用大数据平台。他还曾是两家初创公司(Mojave Design和Performance Signal Integrity,现在属于Synopsys旗下)的共同创始人。他毕业于卡内基梅隆大学,并荣获学士和硕士学位。
内容推荐 | 先进的多物理场仿真:3D-ICs with Ansys RedHawk-SC Electrothermal

Sooyong Kim | Ansys产品总监及专家
Sooyong Kim目前是Ansys产品总监及专家,主要负责3D IC和芯片封装系统多物理场解决方案。他拥有约20年的EDA行业经验,专注于电源完整性,可靠性分析和方**。在2008年加入Ansys半导体事业部(前为Apache Design Solutions)后,曾在现场运营和客户支持方面担任过各种职务。在此之前,曾在Cadence Design Systems工作8年。他在纽约州特洛伊市的伦斯勒理工学院获得了电气工程的学士和硕士学位。











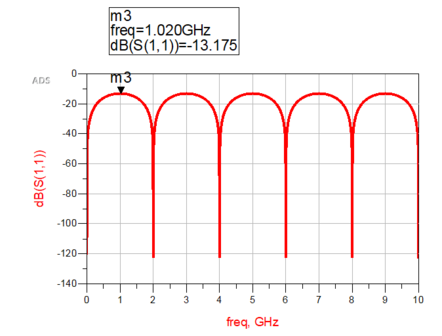

.png?imageView2/2/h/336)
