
芯片设计仿真(三) :散热仿真在封装中的应用
开播时间:2023-04-09 19:30:00主讲嘉宾:仿真圈
现在Chiplet的封装方案被认定为延续摩尔定律的最佳解决方案,也是利用interposer将各个不同功能芯片封装在一起,做出多层功能芯片利用TSV连接在,被称为3D封装。HBM就是一种3D封装,不过是属于小规模的3D封装,大规模的3D封装中热、应力以及信号完整性问题会更加严峻,等待有经验的工程师去解决。
3月23日至4月20日,仿真秀将邀请芯片行业资深的芯片封装工程师带来6场讲座,一起探索芯片设计、结构散热、SIPI和EMC仿真解决方案。

一、本期授课嘉宾
惊堂木 电子封装系硕士,仿真秀专栏作者,某知名芯片厂封装仿真工程师,熟悉封装领域散热设计与应力仿真。
二、直播大纲
(1) JEDEC 热测试标准解读与热仿真模型;
(2) 封装中复杂热阻网络模型提取与应用;
(3) 封装瞬态热阻(R-C热阻抗)介绍;
(4) 封装散热优化方案分享;
(5) 互动答疑
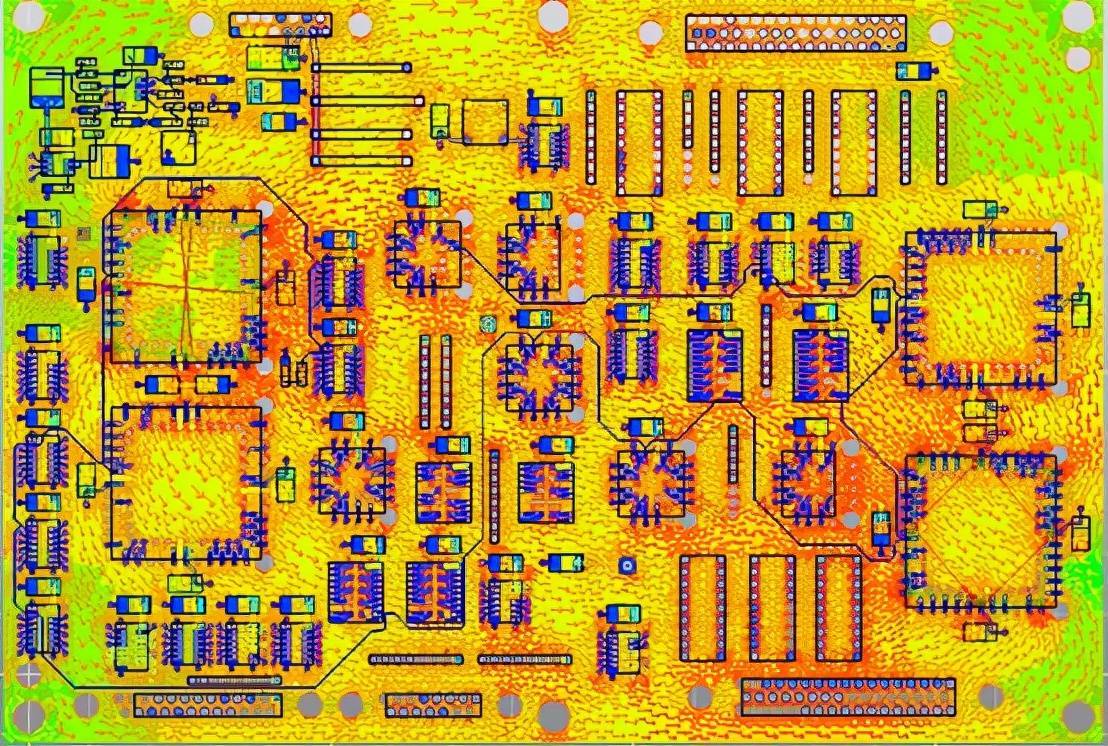
三、用户得到
讲座将分享芯片封装领域的一些热仿真研究的内容。JEDEC热阻测试标准与热仿真模型; 单芯片热阻网络模型的应用与热阻网络的提取; 瞬态热仿真与瞬态热阻的应用; 最后分析一些常见封装散热优化方案。
(1) JEDEC 热测试标准解读与对应热仿真模型;
(2) 封装中复杂热阻网络模型提取与应用;
(3) 封装瞬态热阻(R-C热阻抗)介绍;
(4) 封装散热优化方案分享;
四、适听人群
1、理工学学子和高校教师;
2、有志于解决芯片制程常见问题和应用的任何人
3、有限元分析/热学/材料科学的兴趣爱好者和应用者
五、如何报名
扫码观看,支持朋友圈收藏回看,欢迎申请进芯片仿真技术交流群




